发布日期:2026-02-19 19:53 点击次数:203

1月23日音信,据外媒wccftech报说念,在近日的NEPCON Japan 展会上,英特尔首度公开展示了合并EMIB 与玻璃基板(Glass Substrate)的先进封装。
报说念称,英特尔晶圆代工部门这次展示的是一款“厚中枢(Thick Core)玻璃基板”设想,接收EMIB(Embedded Multi-die Interconnect Bridge)进行多芯粒互连,定位明确指向高性能筹谋(HPC)与AI 业绩器阛阓。该决策被英特尔态状为业界首款玻璃基板+EMIB 组合实例。
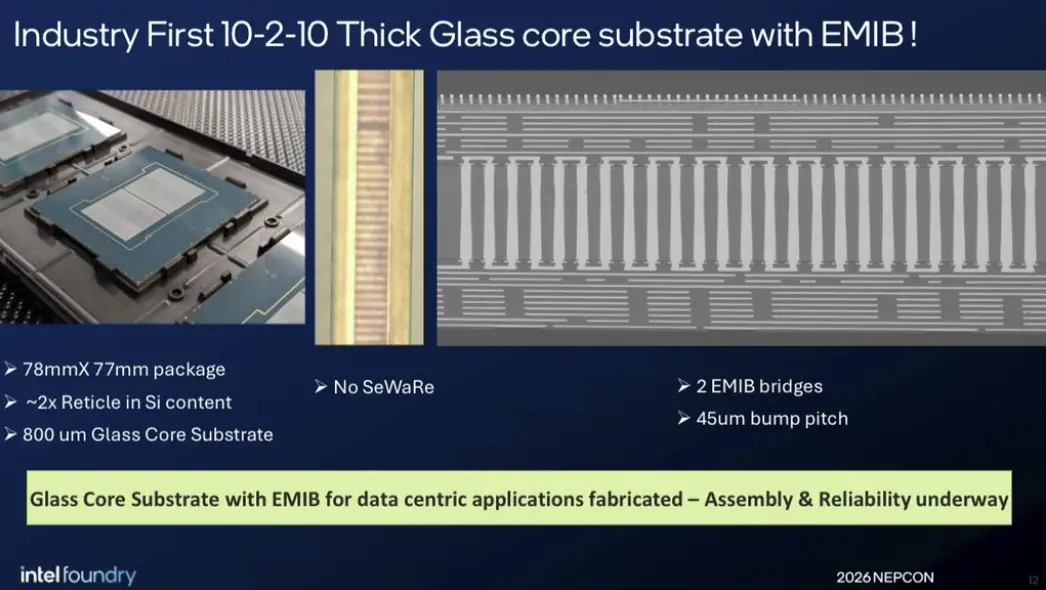
从技能规格来看,亚搏体育官方网站 - YABO该封装尺寸达78mm×77mm,可支握 2 倍reticle 领域,举座结构采10-2-10 堆叠架构,包含10 层RDL、2 层玻璃中枢层与10 层下方build-up 层,亚搏即便在高密度设想下,仍可防守考究布线才调。英特尔也已在封装中整合两条EMIB 桥接结构,用以连合多颗筹谋芯粒,对应异日多chiplet GPU 或AI 加快器需求。
英特尔在简报中相称标示该决策为“No SeWaRe”,泄露其并非锁定糟践性居品,而是为业绩器品级、万古分高负载运作的欺诈所设想。相较传统有机基板,玻璃基板具备更佳的尺寸雄伟性、布线考究度与机械应力实现才调,有助于相沿更大领域、多晶粒的封装整合。
在先进封装产能握续吃紧、AI 与HPC 晶片对整合密度条目胁制提高的配景下,EMIB 技能比年已受到多家HPC 业者关怀。英特尔这次同步展示玻璃基板实作,也被视为其在先进封装竞局中,握续押注高阶AI 与数据中心阛阓的伏击信号。
裁剪:芯智讯-林子